
KLA dévoile un système de métrologie par rayons X innovant
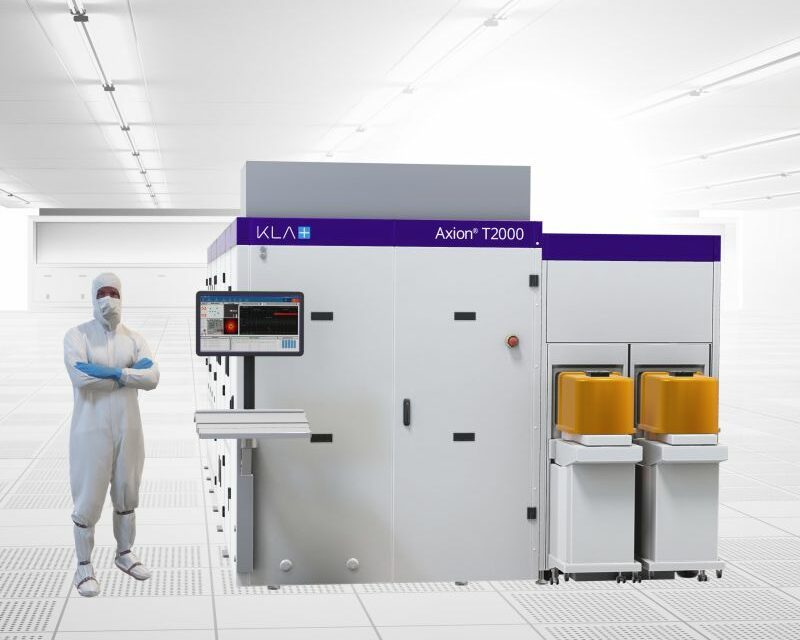
La technologie de rayons X transmissifs de l’Axion T2000 permet de générer rapidement une visualisation 3D complète des structures à rapport d’aspect de l’ordre de 100:1 ou plus, pour les Nand et Dram 3D.
La fabrication de puces Nand et Dram 3D implique la formation précise de structures extrêmement hautes avec des « trous » et des « tranchées » profondes et étroites, ainsi que d’autres formes architecturales complexes, l’ensemble nécessitant un contrôle à l’échelle nanométrique.
Pour répondre aux défis de la mise à l’échelle verticale dans la fabrication des puces mémoire, l’Américain KLA vient de dévoiler le système de métrologie par rayons X Axion T2000. « Notre nouveau système change la donne pour le contrôle des processus en ligne pendant la fabrication de dispositifs Nand et Dram 3D avancés », affirme Ahmad Khan, président de l’activité Semiconductor Process Control de KLA.
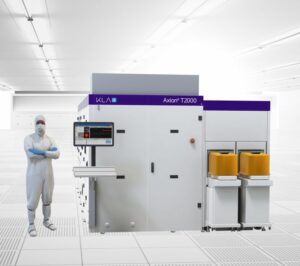 L’Axion T2000 utilise la technique de mesure non destructive CD-SAXS (Critical-Dimension Small Angle X-ray Scattering) et met en œuvre une source à haut flux, qui fournit des rayons X traversant toute la structure verticale de la mémoire, quelle que soit sa hauteur actuelle ou future, un détecteur haute résolution et une platine permettant d’obtenir des images de diffraction sous plusieurs angles.
L’Axion T2000 utilise la technique de mesure non destructive CD-SAXS (Critical-Dimension Small Angle X-ray Scattering) et met en œuvre une source à haut flux, qui fournit des rayons X traversant toute la structure verticale de la mémoire, quelle que soit sa hauteur actuelle ou future, un détecteur haute résolution et une platine permettant d’obtenir des images de diffraction sous plusieurs angles.
« La technologie de rayons X transmissifs permet de générer rapidement une visualisation 3D complète des structures à rapport d’aspect de l’ordre de 100:1 ou plus », précise Ahmad Khan. Et ce avec une combinaison unique de résolution, d’exactitude, de précision et de vitesse. Les données issues du nouveau système facilitent le contrôle rigoureux des paramètres critiques, tels que la largeur, la forme et l’inclinaison.
Autres éléments du nouveau système de KLA, les nouveaux algorithmes AcuShape facilitent la mesure de nombreux paramètres critiques du dispositif et l’extraction de variations subtiles qui peuvent affecter la fonctionnalité finale de la puce mémoire.
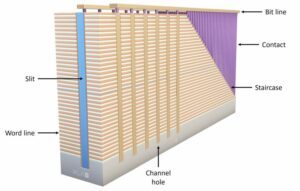
Structure Nand 3D montrant les caractéristiques de rapport d’aspect élevé (High-Aspect Ratio ou HAR), telles que le trou de canal et la fente.
En identifiant ces anomalies de forme, l’Axion T2000 aide les fabricants de mémoires à réaliser des cycles d’apprentissage rapides en R&D, réduisant ainsi la dépendance à l’égard des méthodes de mesure destructives, telles que la FIB-SEM (microscopie électronique à balayage à faisceau d’ions focalisé), la TEM (microscopie électronique en transmission) et la SEM (microscopie électroniques à balayage) en coupe transversale.
Les industriels disposent également d’un moyen leur permettant d’accélérer le temps de cycle de rampe par une caractérisation et une optimisation rapides et précises des nouveaux processus, nœuds de conception et dispositifs et de surveiller et contrôler les étapes clés du processus en ligne, pour s’assurer que les variations qui affectent la qualité des dispositifs sont identifiées et traitées rapidement pendant la production en grande série.
L’Axion T2000 contribue donc à assurer la réussite de la fabrication des puces mémoires utilisées dans des applications telles que la 5G, l’intelligence artificielle (IA), les centres de données et l’informatique périphérique.