
Le système optique inspecte les wafers de SiC
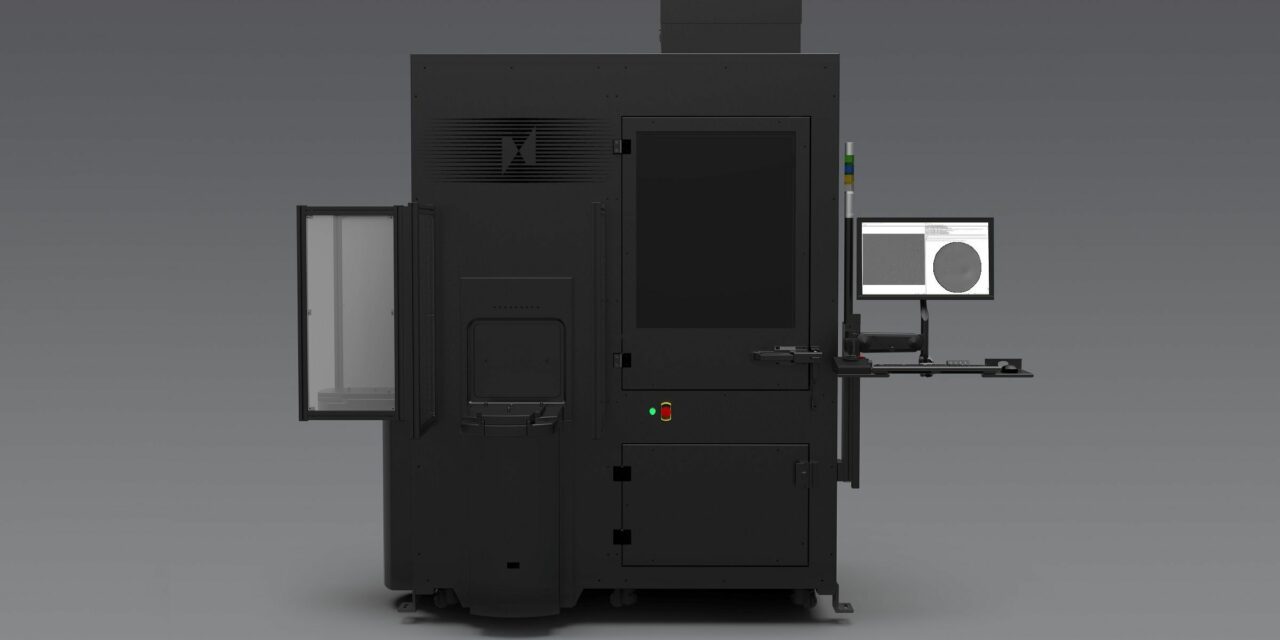
Nanotronics a développé un système d’inspection optique automatisé, qui s’affranchit des méthodes de test destructives pour la fabrication de tranches frontales de SiC et de dispositifs.
Le Japonais Nanotronics a annoncé le lancement du dernier-né de sa gamme de systèmes d’inspection optique automatisés nSpec, à savoir le modèle nSpec PRISM. Cette solution, qui s’affranchit des méthodes de test destructives telles que la gravure KOH, est destinée à la fabrication de tranches frontales de SiC, du substrat de SiC non poli à l’épitaxie, et à la fabrication de dispositifs.
Le système nSpec PRISM associe la microscopie de transmission et la microscopie à photoluminescence pour effectuer l’inspection à haut volume des défauts critiques de SiC, tels que les micropipes et les dislocations.

« Le nouvel illuminateur personnalisé est un élément crucial de notre conception modulaire, permettant à nos clients d’élargir leurs capacités de détection et de classification des défauts directement dans l’usine », affirme Jacob Keith, Director of Product APAC chez Nanotronics.
Couplé à l’infrastructure d’intelligence artificielle (IA) nTelligence du Japonais, le système nSpec PRISM permet aux industriels de détecter et classer les défauts d’empilement, les triangles et d’autres défauts d’intérêt sur les tranches épitaxiales de SiC, ainsi que les fissures et les lignes de glissement dans le GaN.
« Avec cet illuminateur personnalisé, nous contribuons également à réduire les pressions sur la chaîne d’approvisionnement mondiale et à maintenir nos délais de livraison et de support efficaces », ajoute Jacob Keith.


















