
Localiser simultanément plusieurs défauts sur les circuits de micropuces

Des chercheurs du NIST ont développé une méthode, surnommée EFM induite par une polarisation à distance et qui consiste à appliquer une tension alternative déphasée aux fils et non à la pointe de l’AFM.
Les puces informatiques défectueuses sont le fléau de l’industrie des semi-conducteurs. Même un défaut apparemment mineur dans une puce remplie de milliards de connexions électriques peut entraîner l’échec d’une opération critique dans un ordinateur ou un autre appareil électronique sensible.
En modifiant une technique existante d’identification des défauts, des chercheurs du National Institute of Standards and Technology (NIST) ont mis au point une méthode capable de localiser simultanément des défauts électriques individuels dans plusieurs microcircuits sur la même puce.

La pointe métallique illustrée d’un microscope à force atomique (AFM) survole un microcircuit sur une puce. [Crédit : S. Kelley/NIST]
Mais la méthode de recherche de défauts avec un AFM, connue sous le nom de microscopie à force électrostatique (Electrostatic Force Microscopy ou EFM), présente un inconvénient. La vibration de la pointe est affectée non seulement par le champ électrique statique du fil étudié, mais aussi par les tensions de tous les fils voisins. Ces signaux interfèrent donc avec la capacité de visualiser clairement les défauts dans le fil balayé.
Les scientifiques du NIST Joseph Kopanski, Evgheni Strelcov et Lin You ont résolu le problème en appliquant la même tension alternative, mais exactement déphasée, aux fils voisins qu’au fil balayé par la pointe de l’AFM. Ces tensions spécifiques sont fournies par un générateur externe.
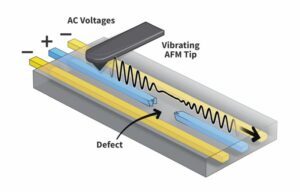
Des tensions alternatives déphasées (indiquées par + et -) sont appliquées aux fils voisins. Un défaut se manifeste par un changement net de la vibration de la pointe lorsqu’elle est déplacée le long du fil. [Crédit : S. Kelley/NIST]
Avec une puce de test comportant quatre paires de fils enfouis à 4 µm sous la surface, les scientifiques ont démontré que leur technique produisait des images claires et précises des défauts. Et, en adaptant les tensions alternatives appliquées à chaque fil pour qu’elles aient des fréquences différentes, les chercheurs ont aussi montré pouvoir visualiser des défauts dans plusieurs fils adjacents en même temps.
« Appliquer une tension aux fils et non à la pointe de l’AFM peut sembler une petite innovation, mais cela fait une grande différence. La méthode, surnommée EFM induite par une polarisation à distance, ne nécessite en effet pas de nouvel instrument et pourrait être facilement mise en œuvre par l’industrie des semi-conducteurs », avance Joseph Kopanski. D’autres techniques, comme les rayons X ou les champs magnétiques, repèrent précisément les défauts, mais nécessitent un équipement plus coûteux.





















